
ecosnos.ru

 |
ecosnos.ru |
 |
|
Главная Пьезорезистивные чувствительные элементы 1 2 3 4 5 6 7 8 9 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 [ 50 ] 51 52 53 54 55 56 57 58 59 60 61 62 63 64 65 66 67 68 69 70 71 72 73 74 75 76 77 78 79 80 81 82 83 84 85 86 Глава 4- Конденсаторы и катушки индуктивности величины перемещения верхней пластины, что приводит к невозможности точной регулировки конденсатора. вид 400 мкм сверху 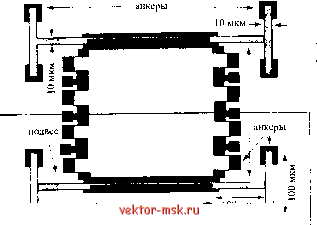 400 мкм 0.5 мкм золсуго 1.5 мкм ро1у2, воздушный зазор 2.0 мкм polyl фиксированная пластина подвешенная пластина + поперечное сечение  выступы воздушный зазо] 0.5 мкм polyO фиксированная пластина Рис. 4.35. Вид сверху и поперечное сечение трехпластинного варактора. Репродукция из книги А. Dec, К. Suyama, 1998b, Microma-chined electromechanically tunable capacitors and their applications to RF ICs , IEEE Transactions on Microwave Theory and Tech- ~ niques 46(12): 2587-2596 с разрешения IEEE, ©1998 IEEE Установлено, что селективное удаление кремниевой подложки из-под пассивного элемента методом травления - эффективный способ улучшения его рабочих характеристик. Например, МДМ-конденсатор (МДМ - структура металл-диэлектрик-металл), изготовленный на подвешенной мембране, при емкости 2.6 пФ на частоте 2 ГГц обладает добротностью более 100, тогда как аналогичный конденсатор, сформированный непосредственно на кремниевой подложке, при тех же условиях показал добротность меньше 10 (Sun, Tau-ritz, Baets, 1999). На рис. 4.37 представлена фотография подвешенного МДМ-конденсатора, управляемого электростатическим способом.  4.4- Микроконденсаторы Рис. 4.36. Фотография со сканирующего микроскопа поднятой пластины MESA-конденсатора. Репродукция из книги L. Fan, R.T. Chen, А. Nepolsa, М.С. Wu, 1998, Uni-versal MEMS platforms for passive RF components: suspended inductors and variable capacitors*. Proceedings of 11* Annual International Workshop on MEMS 98, IEEE, Washington, DC: 29-33 с разрешения IEEE, ©1998 IEEE Конденсаторы изготавливаются на стандартной кремниевой подложке р-типа с ориентацией кристаллов (100) и удельным сопротивлением 3.5 Ом см, на которую наносятся два слоя металла: Ml - толщиной 0.6 мкм и М2 - толщиной 1.4 мкм. Слой Si3N4 наносится методом химического осаждения из газовой фазы при низком давлении. Для получения МДМ-конденсаторов с большими значениями емкости при маленькой площади пластин между двумя металлическими слоями наносится слой AI2O3. После нанесения слоев металлизации наносится шаблон пассивного элемента и производится селективное удаление нижележащего кремния методом жидкостного травления при помощи КОН. Рис. 4.37. Фотография подвешенного МДМ-конденсатора. Репродукция из книги Y. Sun, J.L. Tauritz, R.G.F. Baets, 1999, Mi-cromachined RF passive components and their applications in MMICs , International Journal of RF and Microwave CAE 9: 310-325, ©Wiley (1999) с разрешения Wiley конденсатор 100 мкм Бьи реализован электростатический переменный микроконденсатор с цифровым управлением (Hoivic et al, 2001), имеющий коэффициент перестройки 4 : 1 и добротность на частоте 750 МГц, индивидуальное падение пластин нижний электрод Рис. 4.38. Схема переменного конденсатора с наборной верхней пластиной. Репродукция из книги N. Hoivic, М.А. Michalicek, Y.C. Lee, К.С. Gupta, V.M. Bright, 2001, (.Digitally controllable variable high-Q MEMS capacitor for RF applications)). Proceedings of IEEE MTT-S Symposium, May 2001, Volume 3, IEEE, Washington, DC: 2115-2118 с разрешения IEEE, ©2001-IEEE Для расширения диапазона настройки переменные микроконденсаторы могут использовать двойные согласующие шлейфы (Lang et al, 2001) и регулируемые преобразователи импеданса (Jung et al, 2001). 4-4-1-- Электротермические переменные микроконденсаторы Как указывалось в предыдущем разделе, диапазой настройки электростатических микроконденсаторов ограничивается 2/3 первоначального зазора между параллельными п.аастинами, что приводит к теоретическому 50% пределу регулировки. Это ограничение по настройке можно преодолеть, используя термический способ управления (Feng et al, 2000а, 2000b, Harsh et al, 1999, Wu et al, 1998). Термический принцип регулирования величины зазора основан на разности теплового расширения толстой и тонкой пластин привода. выполненных из поликремния (рис. 4.39), Был изготовлен переменный конденсатор, управляемый вертикальным электротермическим приводом (Feng et al, 2001, Harsh et al, 2000, Young, Boser, 1996), который продемонстрировал при величине емкости 0.1 пФ на частоте 10 ГГц добротность, равную 300. При этом электротермический привод управлял верхней пластиной конденсатора. GaAs или керамика Кремний является проводником и для улучшения добротности должен быть удален после сборки Рис. 4.39. Сборка кремниевого микроконденсатора методом перевернутого кристалла. Репродукция из книги K.F. Harsh, В. Su, W. Zhang, V.M. Bright, Y.C. Lee, 2000, The realization and design considerations of flip-chip integrated MEMS tunable capacitor.), Sensors and . Actuators A: Physical 80: 108-118 с разрешения Elsevier Science, ©2000 Elsevier Science Вертикальное перемещение электротермического привода осуществляется за счет теплового рассогласования, вызванного разным распределением температур. Электротермический привод управляется за счет разного расширения широкого и узкого плечей, изготовленных из поликремния. Узкое плечо расширяется сильнее, заставляя привод складываться, что вызывает изменение зазора и, соответственно, емкости. Такой микроконденсатор хорошо работает на частотах миллиметрового диапазона, благодаря тому, что он собран методом перевернутого кристалла и перенесен с кремниевой подложки, обладающей большими потерями, на подложку из окиси алюминия с низкими потерями. Кремниевая подложка, используемая для построения многих ми-кро(;т'руктур, не подходит для изготовления ВЧ устройств без модификации традиционной технологии. Одной из таких модификаций является монтаж методом перевернутого кристалла и закрепление микроустройства на керамической подложке, описанный в работе (Harsh et al, 1999). Этот метод используется для оптимальной интеграции микроструктур в существующие схемы или изготовления микроструктур на новой поверхности. На рис. 4.39 показана схема изготовления микроконденсатора на GaAs или керамической под- равную 140. Для регулируемых конденсаторов электростатический способ управления предпочтительнее термического, поскольку при этом достигается быстрая настройка при более высокой стабильности отклонения пластин. В рассматриваемом переменном конденсаторе (рис. 4.38) за счет особой организации верхней пластины удалось достичь линейности изменения емкости в ответ на изменение напряжения. Верхняя пластина здесь состоит из 30 пластин равной площади, каждая из которых имеет собственное балочное крепление разной ширины. При подаче управляющего напряжения верхние пластинки двигаются по направлению к нижней пластине каскадным образом, их передвижение определяется жесткостью индивидуальных креплений. ложке методом перевернутого кристалла. По окончании процесса изготовления микроструктуры кремниевая подложка удаляется. микроустройство отверстия  Рис. 4.40. Схема электротермического переменного микроконденсатора. Репродукция из книги Z. Feng, Н. Zhang, К.С. Gupta, W. Zhang, V.M. Bright, Y.C. Lee, 2001, MEMS-based series and shunt variable capacitors for microwave and millimeter-wave frequencies*. Sensors <j - and Actuators A: 91 256-265 с разрешения Elsevier Science, ©2000 Elsevier Science Ha рис. 4.40 представлена схема переменного электротермического конденсатора, а на рис. 4.41 - фотография такого микроконденсатора, изготовленного на керамической подложке. Проведенные исследования показали, что при изменении напряжения смещения в диапазоне 0.,. 2.5 В коэффициент регулирования емкости такого микроконденстора составляет 2.7 ; 1. На рис. 4.42 и 4.43 приведены экспериментально полученные характеристики рассматриваемого конденсатора. Использование электротермического привода для регулирования емкости является довольно перспективным методом построения переменных конденсаторов, поскольку он снимает 50% ограничение по настройке, характерное для всех электростатических микроконденсаторов. Однако электротермические приводы имеют низкое быстродействие и сравнительно больщую потребляемую мощность: порядка 10 мА при ЗВ. Рис. 4.41. Микрофотография электротермического переменного микроконденсатора. Репродукция из книги K.F. Harsh, В. Su, W. Zhang, V.M. Bright, Y.C. Lee, 2000, The realization and design considerations of flip-chip integrated MEMS tunable capacitor*. Sensors and Actuators A: Physical 80: 108-118 с разрешения Elsevier Science, ©2000 Elsevier Science  перемещение перемещение пластины конденсатора термического ..... -, . привода пластина конденсатора  электротермический привод Рис. 4.42. Зависимость емкости микроконденсатора от напряжения смещения. Репродукция из книги K.F. Harsh, В. Su, W. Zhang, V.M. Bright, Y.C. Lee, 2000, The realization and design considerations of flip-chip integrated MEMS tunable capacitor*. Sensors and Actuators A: Physical 80: 108-118 с разрешения Elsevier Science, © 2000 Elsevier Science  приложенное напряжение, В Недостаток всех микроконденсаторов с регулируемым зазором - невозможность работы с мощными ВЧ сигналами, что объясняется малой величиной зазора между пластинами. При настройке конденсатора на большие значения емкости пластины сближаются ближе и |