
ecosnos.ru

 |
ecosnos.ru |
 |
|
Главная Пьезорезистивные чувствительные элементы 1 2 3 4 5 6 7 8 9 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 [ 25 ] 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 50 51 52 53 54 55 56 57 58 59 60 61 62 63 64 65 66 67 68 69 70 71 72 73 74 75 76 77 78 79 80 81 82 83 84 85 86 I 58 Глава 2. Материалы и методы изготовления микросистем расщепитель луча 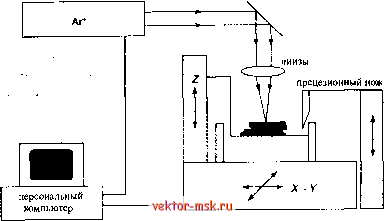 Рис. 2.21. Установка МСЛ для керамики Глубина полимеризации определяется следующим выражением (Gardner, Varadan, Awadelkarim, 2001, Varadan, Xiang, Varadan, 2001): где fAnV (2.75) (2.76) Здесь Ф - средний размер частиц керамической пудры, - доля объема, занимаемого керамическим материалом в суспензии, п - коэффициент преломления раствора мономеров. An - разница между коэффициентами преломления керамического и мономерного растворов, а Л - длина волны УФ излучения. Этапы изготовления керамических микроструктур показаны на рис. 2.22. Первый этап заключается в подготовке керамической суспензии. Субмикронная керамическая пудра смешивается с мономерами, фотоинициаторами, дисперсантами, разжижителями и т. д. в течение нескольких часов в шаровой мельнице. Готовая керамическая суспензия помещается в емкость, где проводится ее УФ облучение в соответствии с изображением в CAD формате. После этого полученную промежуточную керамическую структуру ставят в печь, где сначала происходит выжигание полимерных связей, а потом высокотемпературное спекание для формирования плотных керамических элементов. Температура проведения этих процессов определя- 2.7. Изготовление полимерных микросистем ется типом используемых полимерных и керамических материалов. Полученные керамические структуры теперь готовы к дальнейшей сборке или использованию. Рис. 2.22. Этапы 1цля керамики МСЛ разработка маски (CAD формат) подготовка материала: перемешивание мономеров и керамической пудры МСЛ (промежуточная структура) выжигание связующего вещества & высокотемпературная обработка (уплотнение керамики) 2.7.5.2. Металлические микроструктуры Микросистемы часто имеют в своем составе металлические микроструктуры. Для построения 3D металлических микроструктур были разработаны следующие технологии: пространственной формовки, электрохимического изготовления, выборочного выжигания лазером и лазерного плакирования (Cohen et al, 1999, Kathuria, 1996, Taylor et al, 1994). В этом разделе будет дано краткое описание метода пространственной формовки, поскольку он обладает довольно хорошей разрешающей способностью, и, следовательно, перспективен для промышленного производства. Пространственная формовка включает в себя несколько разных технологий, необходимых для изготовления твердых металлических трехмерных элементов из мелкой пудры (Taylor et al, 1994). Подобно тому, как это реализовано в проекционной МСЛ, для построения шаблонов на хромированной маске используются данные о формируемой структуре, хранящиеся в компьютерных CAD моделях. Специально изготовленный пресс офсетной печати наносит негативный матерд1ал (вокруг твердых участков остаются пустые места) на керамическую подложку из нескольких совмещенных слоев толщиной порядка 0.5 мкм, используя для этого пигментированные органические красители. Каждый слой подвергается воздействию УФ излучения. После нанесения определенного количества слоев негативных материалов (например, 30), при помощи специального ножевого приспособления заполняют образующиеся пустоты позитивным красителем, содержащим большое количество металлической пудры (например, 50% объема) (Рис. 2.23, Thornell, Johansson, 1998). Эти за- 160 Глава 2. Материалы и методы изготовления микросистем полненные слои также облучаются УФ светом. Перечисленные операции повторяются до получения требуемой толщины промежуточной структуры (например, 500мкм). Промежуточная структура помещается в программно управляемую печь для удаления органики и проведения процесса спекания. По окончании этого этапа получают чисто металлическую микроструктуру. УФ излучение 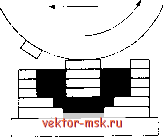 Нанесение красителя  t t t t облучение ТТТТТТТ Заполнение Слой красителя (облученный и необлученный) облучение Облученный слой наполнителя Необлученный слой наполнителя (или подложка) Рис. 2.23. Схема проведения пространственной формовки . . 2.7.6. Объединение методов микростереолитографии и , ТОЛСТО-пленочной литографии Многие компоненты механических микросистем изготавливаются при помощи планарных технологий, таких как поверхностные (тонкопленочные) и объемные методы обработки кремния. Трехмерные структуры с высоким характеристическим соотношением могут быть получены методами LIGA, глубоким реактивно-ионным тра- 2.И. Jaключeнue влением и литографией с использованием толстых слоев резиста. Хотя все эти технологии обладают высокой разрешающей способностью, они не позволяют получать реальные 3D структуры. Для построения сложных трехмерных элементов применяются методы МСЛ, но при этом появляются проблемы, связанные с их невысо-. кой разрешающей способностью и дополнительными операциями с полимерными микроструктурами. Объединение технологий МСЛ и толсто-пленочной литографии позволит создать новый метод построения 3D микроструктур, обладающих большей функциональностью (Bertsch, Lorenz, Renaud, 1998). Для этих случаев подходит материал EPON SU-8, свойства которого описаны в разделе 2.4.3, а в главе 6 приведен пример его применения для построения фазовращателей. 2.8. Заключение в этой главе приведено описание материалов и полимеров, а также методов изготовления механических микроустройств, находящихся на начальных стадиях разработки. Также здесь кратко представлены методы объемной и поверхностной обработки кремния с различными техниками монтажа и построения барьерных слоев для остановки процесса травления. В дополнение к этому дан обзор МСЛ и способов ее объединения с другими технологиями. МСЛ является очень перспективным методом, поскольку позволяет изготавливать недорогие реальные 3D структуры из широкого диапазона материалов, полимеров, металлов и керамики. Здесь также обсуждались методы поверхностной обработки, применяемые для реализации полимерных микросистем. - . , Литература Apel, и., Graf. H.G., Harendt, С, HofHinger, В., Ifstrom, Т., 1991, А lOOrV.Aateral DMOS transistor with а 0.3 micron channel in a 1 micron silicon-film-on-insulator-on silicom, IEEE Transactions on Electronic Devices 38: 1655-1659. Beluze, L., Bertsch, A., Renaud, P., 1999, Microstereolithography: anew process to build complex three-dimensional objects*, Proceedings of SPIE 3680: 808-0-817. Bertsch, A., et al., 1997, Microstereolithography using a hquid crystal display as dynamic mask generator*. Microsystem Technology 3: 42-47. Bertsch, A., Zissi, S., Jezequel, J.Y., Corbel, S., Andre, J.C., 1997, Microstereolithog-raphy using a liquid crystal display as dynamic mask generator*. Microsystem Technologies 3: 42-47. Bertsch, А., Lorenz, Н., Renaud, Р., 1998, (.Combining microstereolithography and thick resist UV lithography for 3D microfabrication*, in IEEE Proceedings of MEMS 98, IEEE, Washington, DC: 18-23. Chomnawang, N., Lee, J.-B., 2001, On-chip 3D air core microinductor for high frequency applications using deformation of sacrificial polymer . Proceedings of SPIE 4334: 54-62. Cohen, A., Zhang, G., Tseng, F.-G., Prodis, U., Mansfeld, F., Will, P., 1999, <.EFAB: rapid Jow-cost desktop micromachining of high aspect ratio true three-dimensional MEMSi), in Proceedings of IEEE MEMS, IEEE, Washington, DC: 244-251. Cukauskas, E.J., Kirchoefer, S.W, Pond, J.M., 2000, <.Low-loss BaO.5 SrO.5 TiOs thin films by inverted magnetron sputtering)). Journal of Applied Physics 88(5): 2830-2835. Dellmann, L., Roth, S., Beuret, C, Racine, G.A., Lorenz, H., Despont, M., Renaud, P., Vettiger, P., De Rooij, N.F., 1997, (.Fabrication process of high aspect ratio elastic structure for piezoelectric motorapplicationS)>, Proceedings of the International Conference on Solid State Sensors and Actuators, Transducers 97, Chicago, Volume 1, 641-644. Despont, M., Lorenz, H., Fahrni, N., Brugger, J., Renaud, P., Vettiger, P., 1998, High aspect-ratio, ultra-thick, negative-tone near-UV photoresist for MEMS ар-plications , Sensors and Actuators A 64: 33-39. Ding, X., Kuribayashi, K., Hashida, Т., 1999, (.Development of a planar type micro electro magnetic distance sensor using high aspect ratio photoresist and its applica-tioni), in International Symposium on Micomechatronics and Human Science, IEEE Nagoya, Japan: 227-233. Fouassier, J.-P., 1995, Photoinitiation, Photopolymerization and Photocuring: Fundamentals and Applications, Hanser/Gaxdener, New York. Gardner, J.W., Varadan, V.K, Awadelkarim, O., 2001, Microsensors, MEMS and Smart Devices, John Wiley, Chichester, UK. Guerin, L., Bossel, M., Demierre, M., Calmes, S., Renaud, P., 1997, (.Simple and low cost fabrication of embedded microchannels by using a new thick film photoplastic . Proceedings of the International Conference on Solid State Sensor and Actuators, Part 2. IEEE, NJ: 1419-1422. Haertling, C.L., 1989, (.Patterned ceramics for multilayer packaging using ultraviolet curabe pastes , M.Sc. thesis, Pennsylvania State University, university park, PA. Harendt, C, Graf, H.G., Hollinger, В., Penteker, E., 1991, (.Silicon direct bonding for sensor applications - characterization of the bond quality . Sensors and Actuators A 25: 87-92. Harriss, J.E., Pearson, L.W., Wang, X., Barron, C.H, Pham, A.V., 2000. (.Membrane-supported Ka band resonator employing organic micromachined packaging*, IEEE MTT-S International Microwave Symposium 2: 1225-1228. Hashimoto, Т., Kikuchi, Т., Watanabe, K., Ohashi, N., Saito, Т., Yamaguchi, H., Wada, S., Nat-suaki, N., Kondo, M., Kondo, S., Homma, Y., Owada, N., Ikeda, Т., 1998, 0.2-mum bipolar-CMOS technology on bonded SOI with copper metallization for ultra high-speed processors, Proceedings of the International Electron Devices Meeting, San Francisco, CA, USA, IEEE, Piscataway, NJ: 209-212. Ikuta, K., Hirowatari, K., 1993, (.Real three dimensional microfabrication using stereolithography and metal molding*, in Proceedings of IEEE MEMS, IEEE, Washington, DC: 42-47. Ikuta, K., Ogata, Т., Tsubio, M., Kojima, S.,.1996, ..Development of mass productive microstereolithography (mass-IH process)*, in Proceedings of IEEE MEMS, IEEE, Washington, DC: 301-305. Ikuta, K., Maruo, S., Kojima, S., 1998, ..New microstereolithography for freely moved three dimensional microstructure-super IH process with submicron resolution*, in Proceedings of IEEE MEMS, IEEE, Washington, DC; 290-295. Kagan, J., 1993, Organic Photochemistry: Principles and Applications, Academic Press, New York. Kai, C.C., 1994, ((Three-dimensional rapid prototyping technologies and key development areas*, Computing & Control Engineering Journal 5(4): 200-206. Kathuria, Y.P, 1996, (.Rapid prototyping: an innovating technique for microfabrication of metaUic parts*, in Proceedings of the 1996 7th International Symposium on Micro Machine and Human Science, MHS 96, October 2-4, Nagoya, Japan, IEEE Piscataway, NJ: 59-65. LaBianca, N., Delorme, J., 1995, (.High aspect ratio resist for thick film applications* Proceedings of SPIE 2438: 846-852. Lasky, J.B., 1986, (.Wafer bonding for silicon-on-insulator technologies*. Applied Physics Letters 48: 78-80. Lee, K., LaBianca, N., Rishton, S., Zohlgharnain, S., 1981, (.Micromachining applications for a high resolution ultra-thick photoresist*, Journal of Vacuum Science and Technology В 13: 3012-3016. Levin, I., Leapman, R., Kaiser, D.L., 2000, ..Microstructure and chemistry of non-stoichiometric (Ba,Sr)Ti03 thin films deposited by metalorganic chemical vapor deposition*, Journal of Malerials Research 15: 1433. Li, H.C., Si, W., Wang, R.L., Xuan, Y., Liu, B.T., Xi, X.X., 1998, <.Oxide thin films for tunable microwave devices*. Materials Science and Engineering В 56: 218. Liu, W.Y., Steenson, D.P, Steer, M.B., 2001, ..Membrane -supported CPW with mounted active devices*, IEEE Microwave and Wireless Components Letters 11: 167-169. Lorenz, H., Despont, M., Fahrni, N., Labianca, N., Renaud, P., Vettiger, P., 1997, SU-8: a low cost negative resist for MEMS*, Journal of Micromechanics and Microengineering 7: 121-124. Maruo, S., Kawata, S., 1998, ..Two-photon-absorbed near-infrared photopolymerization of three dimensional microfabrication*, Journal of Microelectromechanical Systems 5: 24-32. McCormick, M.A., Roeder, R.K, Slamovich, E.B., 2001, ..Processing effects on the composition and dielectric properties of hydrothermally derived BaxSri-TiOs thin films*, Journal of Materials ResearchXQ: 1200. Monneret, S., Loubere, V., Corbel, S., 1999, (.Microstereolithography using a dynamic mask generator and noncoherent visible light source>>, Proceedings of SPIE 3680: 553-561. Nakamoto, Т., Yamaguchi, K., 1996, ..Consideration on the producing of high aspect ratio microparts using UV sensitive photopolymer*, in Proceedings of the 1996 7th International Symposium MicroMachme and Human Science, MHS 96, October 2-4, Nagoya, Japan, IEEE, Piscataway, NJ: 53-58. Nazeri, A., Khan, M., 1995, ..Strontium-barium-titanate thin films by sol-gel processing*, Jourfial of Material Science Letters 14 :1085. Pappas, S.P., 1992, Radiation Curing: Science and Technology, Plenum, New York. Peeters, E., Lapadatu, D., Puers, R., Sansen, W., 1994, ..PHET, an electrodeless photovoltaic electrochemical etch-stop technique*. Journal of Microelectromechanical Systems 3: 113-123. Sedlar, M., Sayer, M., Weaver, L., 1995, Sol-gel processing and properties of cerium doped barium strontium titanate thin films*. Journal of Sol-gel Science and Technology 5: 201. Suzumori, K., Koga, A., Haneda, R., 1994, ..Microfabrication of integrated FMAs using stereo-lithography*, in Proceedings of IEEE MEMS, IEEE, Washington, DC: 136-141. |