
ecosnos.ru

 |
ecosnos.ru |
 |
|
Главная Пьезорезистивные чувствительные элементы 1 2 3 4 5 6 7 8 9 10 11 12 13 14 [ 15 ] 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 46 47 48 49 50 51 52 53 54 55 56 57 58 59 60 61 62 63 64 65 66 67 68 69 70 71 72 73 74 75 76 77 78 79 80 81 82 83 84 85 86 SiHCl3 + H2Si + 3HCl. (2.4) EGS - это пояшфисталлический кремний очень высокой чистоты, используемый для производства высококачественных подложек. против часоюй стрелки граница раздела твердое состояние - расплав механизм вращения стержня с затравкой - стержень кристаллическ затравка  графитовый держатель гипм Рис. 2.3. Аппарат Чох-ральского для выращивания кристаллов по часоюй стрелке В методе Чохральского используется аппарат, схематично показанный на рис. 2.3. Этот аппарат состоит из трех основных частей: - Печи, в которую входит тигель для расплавления Si02, графитового держателя, вращательного механизма, нагревающего элемента и источника питания - Механизма вытягивания кристалла, включающего в себя стержень с затравкой и устройство для его вращения - Устройства для управления составом атмосферы, состоящего из источника газа (обычно инертного), системы управления потоками и выхлопом. При выращивании кристаллов в тигель помещается EGS и печь нагревается выше температуры плавления кремния. В этот расплав опускается затравочный монокристалл кремния высокого качества и соответствующей ориентации (например, 100). При этом и затравочный кристалл, и тигель вращаются, но в противоположных направлениях. В начале процесса роста часть затравочного кристалла расплавляется, затем происходит постепенное вытягивание стержня с затравкой из расплава. При быстром охлаждении на границе раздела твердое состояние-расплав происходит формирование большого монокристалла кремния. Обычная скорость вытягивания кристалла составляет несколько миллиметров в минуту.  [111]п-тип [111]р-тип  основной срез дополнительный срез [111]п-тип Рис. 2.4. Ориентация кристалла и тип примеси 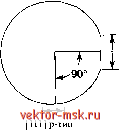 основной срез дополнительный срез После того как процесс выращивания закончен, от монокристалла отделяют затравочную и хвостовую часть. Затем обрабатывается его 15оковая поверхность для получения требуемой толщины. Далее происходит шлифовка одного или нескольких базовых срезов вдоль всей длины полученного кристалла. Эти срезы помогают определить ориентацию кристаллов и тип проводимости материала (рис. 2.4). И, наконец, кристалл разрезается алмазными пилами на пластины. Готовые пластины характеризуются четырьмя параметрами: ориентацией поверхности, толщиной, конусностью (изменением толщины пластины от одного конца до другого) и наклоном При комнатной температуре трихлорсилан является жидкостью. Фракционная перегонка позволяет очистить трихлорсилан от примесей. После чего очищенный SiHCla помещается в водородную среду, где превращается в кремний злектронного качества (EGS): , , Глава 2. Материалы и методы изготовления микросистем (кривизной пластины, измеряемой от центра к краям). Типовые характеристики кремниевых пластин приведены в таблице 2.5. Таблица 2.5. Характеристики кремниевых пластин
2.2.2.2. Эпитаксиальное выращивание Метод получения слоя кремния на подложке известен под названием эпитаксиального выращивания. Здесь в качестве затравки кристаллов используется сама пластина. Этот метод отличается от предыдущего тем, что процесс выращивания эпитаксиального слоя происходит при температурах, гораздо меньших точки плавления. На практике для получения кремниевых слоев чаще других применяется Метод эпитаксиального выращивания из газообразной фазы (ГЭ). Схематично установка для ГЭ показана на рис. 2.5. Здесь показан горизонтальный держатель пластины, выполненный из графи- %х модулей. При протекании химических реакций этот держатель играет роль индукционного нагревателя и источника тепловой энеррии. О О О О О ввод газа О ВЧ нагрев выход 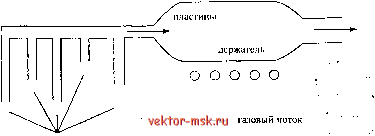 Рис. 2.5. Получение кремниевых слоев методом эпитаксиального выращивания из газовой фазы Обычно используются несколько источников кремния: тетрахло-РИД кремния (SiCU), дихлорсилан (ЗШгСЬ), трихлорсилан (8ШС1з) 8.3. Тонкие пленки и методы их осаждения и силан (SiH4). Типичная температура для протекания реакции с участием тетрахлорида кремния составляет порядка 1200 °С. В этом случае процесс получения кремния происходит в соответствии со следующей химической реакцией: SiCLi (газ) + 2Н2 (газ)-*Si (твердый) + 4НС1 (газ). (2.5) Одновременно протекает и другая реакция: SiCLi (газ) + Si (meepdbiu)~2SiCh (газ). (2.6) При первой реакции кремний наносится на пластину, а по второй удаляется с нее. Следовательно, при чрезмерной концентрации SiCU преобладает второй процесс и нанесения слоя кремния не происходит. Альтернативным методом выращивания слоев кремния является молекулярно-лучевая эпитаксия (МЛЭ), которая проводится в условиях глубокого вакуума (~ 10 Торр) и заключается во взаимодействии между горячим пучком атомов кремния и монокристаллической подложкой. Здесь возможен точный контроль, как за химическим составом, так и за чистотой профилей. Методом МЛЭ можно получить многослойную структуру, состоящую из монокристаллических пленок толщиной, сопоставимой с размером атома. 2.3. Тонкие пленки и методы их осаждения При изготовлении микросистем используются разные виды тонких пленок. Перечислим четыре основных класса материалов, применяемых в микросистемах в виде тонких пленок: - оксид кремния, - диэлектрики, - поликристаллический кремний, - метилы (в основном алюминий), - ферроэлектрики. Диэлектриками считаются пленки из осажденного диоксида кремния (который иногда относят к оксидам) и нитрида кремния. Они используются в качестве изоляторов между проводящими слоями, масок при распылении и имплантации ионов и для защиты микросистем от загрязнений, влаги и царапин. Поликремний применяется для построения электрода затвора в МОП транзисторах (МОП - металл-оксид-полупроводник), а также как проводящий материал © © ® © 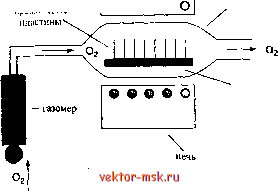 Рис. 2.6. Установка, для термоокисления кремние-кварцевая трубка ых пластин кварцевый держатель Термоокисление - это метод выращивания тонких пленок на поверхности кремниевой пластины. Это ключевой метод получения тонких слоев из ЗЮг, применяемый в современных технологиях изготовления интегральных схем. На рис. 2.6 показана схема установки термоокисления. Она состоит из печи с резистивным нагревателем, цилиндрической кварцевой трубки, в которой находятся кремниевые пластины, вертикально вставленные в щели кварцевого держателя, и источника либо чистого сухого кислорода, либо чистого водяного пара. Конец вводной трубки входит в вертикальный колпак, где происходит фильтрация потока воздуха. Этот колпак уменьшает содержание пыли в воздухе вокруг кремниевых пластин и минимизирует загрязнение в течение всего процесса термоокисления. Термоокисление кремния в кислороде или водяном паре может быть описано следующими химическими реакциями: Si {твердый) + 02{газ) Si02 {твердый), (2.7) Si {твердый) + 2Щ0{газ) °°°°°)Si02 {твердый) + 2Щ{газ). (2.8) Используя значения плотностей и молекулярных весов кремния и диоксида кремния, можно показать, что для получения пленки оксида толщиной X необходимо окислить слой кремния, равный 0.44ж. 2.3.2. Осаждение диоксида и нитрида кремния Для формирования тонкопленочных структур на подложке широко используются три метода осаждения. Все эти методы основаны на химическом осаждении из газовой фазы, перечислим их: - химическое осаждение из газовой фазы при атмосферном давлении, - - химическое осаждение из газовой фазы при низком давлении, - плазменное химическое осаждение из газовой фазы. Самым современным является третий метод. При выборе метода осаждения учитывают следующие данные: температуру подложки, скорость осаждения, однородность пленки, морфологические характеристики, электрические и механические свойства и химический состав диэлектрических пленок. Схема типовой установки для химического осаждения из газовой фазы показана на рис. 2.7. Здесь не отражено, как через входную трубку подаются различные газы. На рис. 2.7 а представлена установка для химического осаждения при низком давлении, а на рис. 2.76 - установка для плазменного химического осаждения. На рис. 2.7 а кварцевая трубка нагревается при помощи трехзонной печи, на одном конце реактора через входную трубку газ вводится, а на противоположном конце - откачивается при помощи насоса. Пластины подложки установлены вертикально в щелевом держателе. Реактор, показанный на рис. 2.7 а, относится к реакторам химического осаждения с горячими стенками, поскольку стенки кварцевой трубки всегда горячие из-за соседства с печью. Существуют также реакторы с холодными стенками, например, горизонтальный эпитаксиальный реактор, который для нагрева использует ВЧ генератор. Приведем типовые технологические параметры для установки химического осаждения при низких давлениях: для многоуровневой металлизации и как материал для контактов в приборах с поверхностными переходами. Металлические пленки используются для низкоомных соединений как в высоколегированных У^+у/р+.зонах, так и в поликремниевых слоях, а также для реализации выпрямляющих (не омических) контактов в парах металл-полупроводник. Как это будет видно из последующих разделов, все эти материалы играют огромную роль при изготовлении микросистем. Поэтому далее будут описаны методы выращивания диоксида кремния и нанесения тонких слоев из диэлектрических, поликристаллических, металлических и ферроэлектрических материалов. 2.3.1. Формирование оксидных пленок методом * термоокисления |
||||||||||||||||||||||||||||||||||||